윈팩, 반도체후공정업체입니다. HBM의 수혜주인거 알았나요?(쉽게설명!)
윈팩 사업
Packaging(85%), Test(12%, Wafer Test, Final Test)/ 주요고객사 : SK하이닉스, 삼성전자
· 패키징(Packaging) : 솔더볼 등을 부착하여 로직칩과 메모리칩 연결 등
· Test : Wafer Test(Probe Test, EDS), Final Test(PKG Test)

기회
· HBM 선두주자 SK하이닉스가 최대 고객사 > OSAT업체 동사에게 수혜 가능성
·
리스크
·
·
업데이트 :
주주구성(23.08월 기준) :

윈팩
패키징(Packaging) : 반도체 칩을 포장하는 일
반도체 전공정이 피자를 만드는 것이라면, 후고정인 패키징은 피자를 포장하는 일로 비유를 들 수 있어요. 패키징은 알몸으로 있는 반도체 칩을 Substrate(기판), PCB(인쇄회로기판) 등에 전기적으로 연결하는 역할을 하죠. 피자를 포장하는 것은 온도유지, 외부이물질 침투 등을 예방하는 역할도 하죠. 패키징도 마찬가지로 칩을 물리적으로 보호하는 역할까지 합니다.
윈팩은 OSAT업체라고 보면 돼요. OSAT은 Outsourced Semiconductor Assembly & Test의 약자로 말 그대로 조립과 검사를 하는 업체를 뜻하는데요. 특히, 윈팩은 패키징(조립)에 대부분의 매출(85%, 23.6월 기준)이 발생하고 있기 때문이죠. 아래 그림은 패키징하는데 최근 가장 주목받고 있는 기술들 입니다. 예를 들면, 플립칩(Flip Chip)은 기존 와이어로 칩과 기판을 이었던 것을 솔더볼, 마이크로 범프 처럼 구슬모양의 볼들을 이용하여 연결하니 더 빠른 속도와 에너지밀도가 획기적으로 커졌어요.
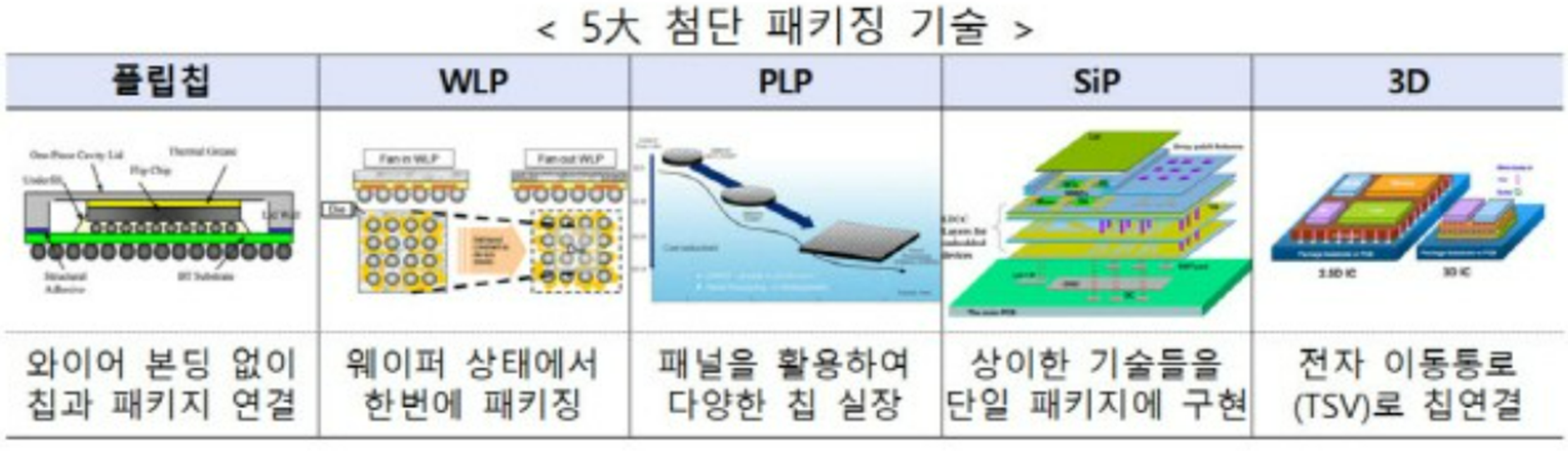
테스트 : 포장된 칩을 검사하는 일
반도체 패키징이 완료가 되었으면, 마지막 관문은 테스트입니다. 패키징하면서 반도체 칩에 손상을 가했을 수도 있고, 패키징된 상태로 칩이 작동을 안할 수 있기 때문에 테스트 공정은 필수로 여겨지고 있어요. 테스트 하는 방법은 Wafer Test 와 Final Test로 나눌 수가 있습니다.
Wafer Test는 전공정이 끝난 후 후공정으로 넘어가기전에 수행하는 작업이에요. 앞서, 패키징된 상태로 테스트를 한다고 했죠. 미리 전공정단에서 하는 이유는 패키징으로 넘어가기 전에 선별적으로 검사를 하면, 굳이 패키징단에서 더 많은 검사를 할 필요가 없어지게 때문이에요. Wafer Test는 EDS 검사라고도 부르는데요. EDS는 Electrical Die Sorting의 약자입니다. 단어 그대로, 전기적(Electrical)으로 칩(Die)를 검사하여 분류(Sorting)하는 것이죠.
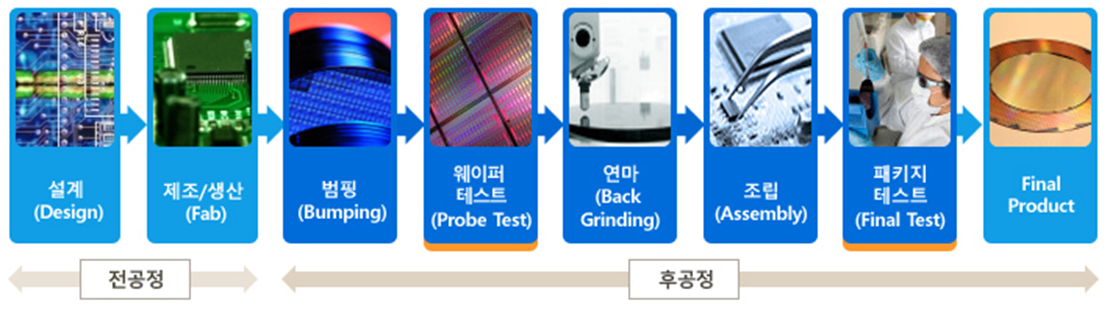
Final Test는 Package Test라고도 불리는데요. 후공정에서 포장이 끝난 상태인 칩을 검사하는 것이죠. 포장까지 끝난 상태인 반도체를 검사하는 것이기 때문에 보통 Final Test라고 부릅니다.
연구실적으로 보는 윈팩의 현 주소 :
개인적으로 윈팩의 연구실적과 연구계획을 보면 동사의 현 상황과 미래 비전이 보인다고 생각을 하는데요. 같이 몇 개만 살펴볼까요.
윈팩의 아래 R&D를 보면, 기존 Wire Bonding 방식으로 연결하던 것은 Flipchip Bond로 대체했다는 것을 알 수 있는데요. 앞서 설명했듯, 와이어는 공간적 제약, 전자간 이동거리 멀어짐, 에너지밀도 작은 것 등 최근에 HPC(High Performance Computting)에는 부족하다는 것을 알 수 있어요. 그래서, 이러한 패키징을 담당하는 윈팩은 적극적으로 Filp Chip을 적용하고 있습니다.


윈팩에 대한 지속적인 업데이트는 맨 위 상단을 참고하면 유익합니다 :)