레이저쎌 사업
Laser Reflow장비(100%, Area Laser=반도체패키징, Mini LED, Probe pins, 전력반도체)/ 경쟁력 : Area Laser(면광원 방식으로 넓은 면적으로 균일한 레이저를 조사) > 매스 리플로우(SMT), TC Bonder 대체 가능성
1. 레이저장비(솔더볼 패키지용) ; 기존 칩과 기판 열압착 방식 > 응력차이로 인한 휘어짐(Warpage) 발생 > 타겟 면적(Area)만 레이저로 조사하여 패키징하는 방식등장 > 사용처 : 반도체패키징, Mini LED, Probe pins, 전력반도체 등
* 응력( (應力): 응할 '응' > 외부힘에 의해 힘이 가해질 때, 저항하는 힘 > 서로다른 기계적 강도일 때 다른 응력 발생 > 휘어짐 발생
* TC Bonder 한계 : 15초 동안 열압착 진행 > 시간, 비용 UP > 대면적 레이저리플로우 장비로 시간단축 가능
기회
·
·
리스크
·
·
업데이트 :
주주구성(24.1월 기준) :

레이저쎌
레이저쎌은 레이저를 조사하여 칩과 기판을 패키징하는 레이저장비를 주력으로 만들고 있어요. 기존에는 칩과 기판을 오븐에서 열압착하여 패키징을 했는데요. 접합부분 뿐만 아니라, 다른 면적에도 열이 가해지기 때문에 휘어짐(Warpage) 현상이 발생했어요. 동사의 레이저장비는 Area Laser라고 부르는데, 필요한 면적(Area)에만 레이저(Laser)를 조사하여 빠르게 패키징하는 것이죠.
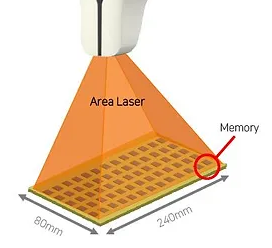
정리
레이저장비(패키지용) ; 기존 칩과 기판 열압착 방식 > 응력차이로 인한 휘어짐(Warpage) 발생 > 타겟 면적(Area)만 레이저로 조사하여 패키징하는 방식등장
* 응력 : 외부힘에 의해 힘이 가해질 때, 저항하는 힘 > 서로다른 기계적 강도일 때 다른 응력 발생 > 휘어짐 발생
연구실적으로 보는 레이저쎌의 현 주소 :
개인적으로 레이저쎌의 연구실적과 연구계획을 보면 동사의 현 상황과 미래 비전이 보인다고 생각을 하는데요. 같이 몇 개만 살펴볼까요.
동사는 BSOM(Beam Shaping Optic Module)이라는 것을 통해 점선인 레이저강원을 면광원(Area Laser)로 바꾸는데요. 점에서 면이 될 때, 면에 퍼져 있는 레이저가 균일해야하겠죠. 그래서, BSOM의 역할이 중요해요. 균일하게 레이저를 면에 분포시켜야 패키징을 할 대 동일한 레이저조사가 가능하기 때문이죠.

레이저쎌에 대한 지속적인 업데이트는 맨 위 상단을 참고하면 유익합니다 :)
'반도체_후공정장비 > Solder Ball Attach' 카테고리의 다른 글
| 덕산하이메탈, 반도체후공정 '솔더 볼' 한 길만 판 업체(쉽게설명!) (1) | 2023.12.26 |
|---|---|
| 코세스, 이오테크닉스의 뒤를 잇는 후공정장비업체 (쉽게설명!) (0) | 2023.09.05 |

